
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiC keramika: Nepostradatelný materiál pro vysoce přesné součástky ve výrobě polovodičů
SiC má jedinečnou kombinaci žádoucích vlastností, včetně vysoké hustoty, vysoké tepelné vodivosti, vysoké pevnosti v ohybu, vysokého modulu pružnosti, silné odolnosti proti korozi a vynikající stability při vysokých teplotách. Jeho odolnost vůči deformaci ohybovým namáháním a tepelnému namáhání jej činí výjimečně vhodným pro drsná, korozivní a ultravysokoteplotní prostředí, se kterými se setkáváme v kritických výrobních procesech, jako je epitaxe plátků a leptání. V důsledku toho SiC našel široké uplatnění v různých fázích výroby polovodičů, včetně broušení a leštění, tepelného zpracování (žíhání, oxidace, difúze), litografie, depozice, leptání a iontové implantace.
1. Broušení a leštění: Brusné susceptory SiC
Po krájení ingotu mají oplatky často ostré hrany, otřepy, odštěpky, mikrotrhlinky a další nedokonalosti. Aby tyto defekty neohrozily pevnost plátku, kvalitu povrchu a následné kroky zpracování, používá se proces broušení. Broušení vyhlazuje okraje plátků, snižuje odchylky tloušťky, zlepšuje rovnoběžnost povrchu a odstraňuje poškození způsobená procesem krájení. Oboustranné broušení pomocí brusných desek je nejběžnější metodou, přičemž neustálý pokrok v materiálu desek, brusném tlaku a rychlosti otáčení neustále zlepšuje kvalitu plátků.
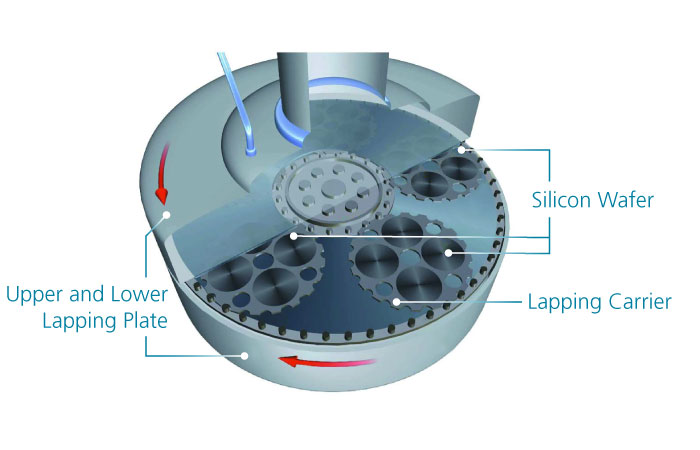
Oboustranný brusný mechanismus
Tradičně se brusné desky vyráběly především z litiny nebo uhlíkové oceli. Tyto materiály však trpí krátkou životností, vysokými koeficienty tepelné roztažnosti a náchylností k opotřebení a tepelné deformaci, zejména při vysokorychlostním broušení nebo leštění, což ztěžuje dosažení konzistentní rovinnosti a rovnoběžnosti plátků. Nástup keramických brusných desek SiC s jejich výjimečnou tvrdostí, nízkou mírou opotřebení a koeficientem tepelné roztažnosti, který se blíží křemíku, vedl k postupnému nahrazování litiny a uhlíkové oceli. Díky těmto vlastnostem jsou brusné desky SiC zvláště výhodné pro vysokorychlostní broušení a leštění.
2. Tepelné zpracování: SiC destičky, nosiče a součásti reakční komory
Kroky tepelného zpracování, jako je oxidace, difúze, žíhání a legování, jsou nedílnou součástí výroby plátků. Keramické komponenty SiC jsou v těchto procesech klíčové, především jako nosiče plátků pro přepravu mezi kroky zpracování a jako komponenty v reakčních komorách zařízení pro tepelné zpracování.
(1)Keramické koncové efektory (ramena):
Při výrobě křemíkových plátků je často vyžadováno vysokoteplotní zpracování. Mechanická ramena vybavená specializovanými koncovými efektory se běžně používají pro přepravu, manipulaci a polohování polovodičových destiček. Tato ramena musí pracovat v prostředí čistých prostor, často ve vakuu, vysokých teplotách a prostředí s korozivními plyny, vyžadujícími vysokou mechanickou pevnost, odolnost proti korozi, stabilitu při vysokých teplotách, odolnost proti opotřebení, tvrdost a elektrickou izolaci. Přestože jsou keramická ramena SiC dražší a náročnější na výrobu, překonávají alternativy z oxidu hlinitého při plnění těchto přísných požadavků.

Semicorex SiC keramický koncový efektor
(2) Součásti reakční komory:
Zařízení pro tepelné zpracování, jako jsou oxidační pece (horizontální a vertikální) a systémy rychlého tepelného zpracování (RTP), pracují při zvýšených teplotách, což vyžaduje vysoce výkonné materiály pro jejich vnitřní součásti. Vysoce čisté slinuté komponenty SiC s jejich vynikající pevností, tvrdostí, modulem pružnosti, tuhostí, tepelnou vodivostí a nízkým koeficientem tepelné roztažnosti jsou nepostradatelné pro konstrukci reakčních komor těchto systémů. Mezi klíčové komponenty patří vertikální čluny, podstavce, vložkové trubky, duše a přepážky.

Součásti reakční komory
3. Litografie: SiC jeviště a keramická zrcadla
Litografie, kritický krok ve výrobě polovodičů, využívá optický systém k zaostřování a promítání světla na povrch destičky, přičemž přenáší vzory obvodů pro následné leptání. Přesnost tohoto procesu přímo určuje výkon a výtěžnost integrovaných obvodů. Litografický stroj jako jedno z nejsofistikovanějších zařízení ve výrobě čipů obsahuje stovky tisíc komponent. Aby byl zaručen výkon a přesnost obvodu, jsou kladeny přísné požadavky na přesnost optických prvků i mechanických součástí v litografickém systému. SiC keramika hraje v této oblasti zásadní roli, především v waferových stupních a keramických zrcadlech.
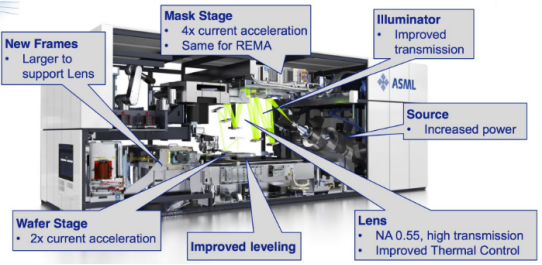
Architektura litografického systému
(1)Fáze oplatky:
Fáze litografie jsou zodpovědné za držení plátku a provádění přesných pohybů během expozice. Před každou expozicí musí být plátek a stolek vyrovnány s přesností na nanometr, následuje zarovnání mezi fotomaskou a stolkem, aby byl zajištěn přesný přenos vzoru. To vyžaduje vysokorychlostní, plynulé a vysoce přesné automatické ovládání stolku s přesností na úrovni nanometrů. Aby byly splněny tyto požadavky, litografické stupně často využívají lehkou keramiku SiC s výjimečnou rozměrovou stabilitou, nízkými koeficienty tepelné roztažnosti a odolností vůči deformaci. To minimalizuje setrvačnost, snižuje zatížení motoru a zvyšuje efektivitu pohybu, přesnost polohování a stabilitu.

(2)Keramická zrcadla:
Synchronizované řízení pohybu mezi waferovým stupněm a nitkovým stupněm je v litografii klíčové a přímo ovlivňuje celkovou přesnost a výtěžnost procesu. Zrcadla stolku jsou nedílnou součástí systému měření zpětné vazby skenování a polohování. Tento systém využívá interferometry k vyzařování měřicích paprsků, které se odrážejí od zrcadel jeviště. Analýzou odražených paprsků pomocí Dopplerova principu systém vypočítává změny polohy stolku v reálném čase a poskytuje zpětnou vazbu systému řízení pohybu, aby byla zajištěna přesná synchronizace mezi stolkem plátku a stupněm záměrného kříže. Zatímco lehká SiC keramika je pro tuto aplikaci vhodná, výroba takto složitých součástí představuje značné problémy. V současné době tradiční výrobci zařízení s integrovanými obvody využívají k tomuto účelu především sklokeramiku nebo cordierit. S pokrokem v materiálové vědě a výrobních technikách však výzkumníci z China Building Materials Academy úspěšně vyrobili velká, složitá, lehká, plně uzavřená keramická zrcadla SiC a další strukturně-funkční optické komponenty pro litografické aplikace.
(3)Fotomask tenké filmy:
Fotomasky, také známé jako mřížky, se používají k selektivnímu přenosu světla a vytváření vzorů na fotocitlivých materiálech. Ozáření EUV světlem však může způsobit výrazné zahřátí fotomasky a potenciálně dosáhnout teplot mezi 600 a 1000 stupni Celsia, což vede k tepelnému poškození. Aby se to zmírnilo, často se na fotomasku nanáší tenký film SiC, aby se zvýšila její tepelná stabilita a zabránilo se degradaci.

4. Plazmové leptání a nanášení: zaostřovací kroužky a další součásti
Při výrobě polovodičů využívají leptací procesy plazmy generované z ionizovaných plynů (např. plynů obsahujících fluor) k selektivnímu odstranění nežádoucího materiálu z povrchu destičky, přičemž zanechávají požadované vzory obvodů. Nanášení tenkého filmu naopak zahrnuje ukládání izolačních materiálů mezi kovové vrstvy za vzniku dielektrických vrstev, podobně jako proces reverzního leptání. Oba procesy využívají plazmovou technologii, která může být korozivní pro součásti komory. Proto tyto součásti vyžadují vynikající odolnost vůči plazmatu, nízkou reaktivitu s plyny obsahujícími fluor a nízkou elektrickou vodivost.
Komponenty v leptacím a nanášecím zařízení, jako jsou zaostřovací kroužky, byly tradičně vyráběny s použitím materiálů, jako je křemík nebo křemen. Neutuchající snaha o miniaturizaci integrovaných obvodů (IC) však výrazně zvýšila poptávku a důležitost vysoce přesných leptacích procesů. Tato miniaturizace vyžaduje použití vysokoenergetického plazmatu pro přesné leptání v mikroměřítku k dosažení menších velikostí prvků a stále složitějších struktur zařízení.
V reakci na tento požadavek se jako preferovaný materiál pro povlaky a součásti v leptacích a nanášecích zařízeních objevil karbid křemíku (SiC) pro chemické nanášení z plynné fáze (CVD). Díky svým vynikajícím fyzikálním a chemickým vlastnostem, včetně vysoké čistoty a jednotnosti, je mimořádně vhodný pro tuto náročnou aplikaci. V současné době mezi komponenty CVD SiC v leptacím zařízení patří zaostřovací kroužky, plynové sprchové hlavice, desky a okrajové kroužky. V depozičním zařízení se CVD SiC používá pro víka komor, vložky a grafitové susceptory potažené SiC.
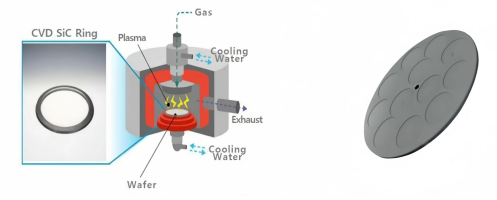
Ohnivý kroužek a grafitový susceptor potažený SiC
Nízká reaktivita CVD SiC s leptacími plyny na bázi chlóru a fluoru spolu s jeho nízkou elektrickou vodivostí z něj činí ideální materiál pro součásti, jako jsou fokusační kroužky v zařízeních pro plazmové leptání. Zaostřovací kroužek, umístěný kolem obvodu plátku, je kritickou součástí, která zaostřuje plazmu na povrch plátku přivedením napětí na kroužek, čímž se zvyšuje jednotnost zpracování.
Jak miniaturizace integrovaných obvodů postupuje, požadavky na energii a energii leptacího plazmatu stále rostou, zejména v leptacím zařízení s kapacitně vázaným plazmatem (CCP). V důsledku toho se používání zaostřovacích kroužků na bázi SiC rychle zvyšuje díky jejich schopnosti odolávat těmto stále agresivnějším plazmovým prostředím.**
Semicorex jako zkušený výrobce a dodavatel dodává speciální grafitové a keramické materiály pro polovodičový a fotovoltaický průmysl. Pokud máte nějaké dotazy nebo potřebujete další podrobnosti, neváhejte nás kontaktovat.
Kontaktní telefon +86-13567891907
E-mail: sales@semicorex.com




