
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Pochopení kompletního procesu výroby polovodičových zařízení
1. Fotolitografie
Fotolitografie, často synonymum pro vytváření vzorů, je jednou z nejkritičtějších hnacích sil stojících za rychlým pokrokem polovodičové technologie, pocházející z procesů výroby fotografických desek v tisku. Tato technika umožňuje prezentaci jakéhokoli vzoru na mikro nebo nanoměřítku pomocí fotorezist, a když je kombinován s jinými procesními technologiemi, přenáší tyto vzory na materiály, čímž se realizují různé návrhy a koncepce polovodičových materiálů a zařízení. Světelný zdroj používaný ve fotolitografii přímo ovlivňuje přesnost vzorů s možnostmi od ultrafialového, hlubokého ultrafialového až po rentgenové a elektronové paprsky, z nichž každý odpovídá zvyšující se úrovni věrnosti vzoru ve zmíněném pořadí.
Standardní proces fotolitografie zahrnuje přípravu povrchu, adhezi, měkké vypalování, expozici, poexpoziční vypalování, vyvolávání, tvrdé vypalování a kontrolu.
Povrchová úprava je nezbytná, protože substráty typicky absorbují molekuly H2O ze vzduchu, což je škodlivé pro fotolitografii. Proto substráty nejprve procházejí dehydratačním zpracováním pečením.
U hydrofilních substrátů je jejich adheze k hydrofobnímu fotorezistu nedostatečná, což může potenciálně způsobit oddělení fotorezistu nebo nesouosost vzoru, takže je potřeba promotor adheze. V současné době jsou široce používanými zesilovači adheze hexamethyl disilazan (HMDS) a tri-methyl-silyl-diethyl-amin (TMSDEA).
Po povrchové úpravě začíná aplikace fotorezistu. Tloušťka naneseného fotorezistu není spojena pouze s jeho viskozitou, ale je také ovlivněna rychlostí odstředivého nanášení, obecně nepřímo úměrná druhé odmocnině rychlosti odstřeďování. Po potažení se provádí měkké vypalování, aby se odpařilo rozpouštědlo z fotorezistu, čímž se zlepšuje přilnavost v procesu známém jako předběžné vypalování.
Jakmile jsou tyto kroky dokončeny, dojde k expozici. Fotorezisty jsou klasifikovány jako pozitivní nebo negativní, s opačnými vlastnostmi po expozici.
Vezměte si pozitivní fotorezist jako příklad, kde neexponovaný fotorezist je nerozpustný ve vývojce, ale stane se rozpustným po expozici. Během expozice světelný zdroj procházející vzorovanou maskou osvětluje potažený substrát a vytváří vzor fotorezistu. Typicky musí být substrát před expozicí zarovnán s maskou, aby se přesně řídila poloha expozice. Doba expozice musí být přísně řízena, aby se zabránilo zkreslení vzoru. Po expozici může být nutné dodatečné vypalování ke zmírnění efektů stojatých vln, ačkoli tento krok je volitelný a lze jej obejít ve prospěch přímého vývoje. Vyvolání rozpouští exponovaný fotorezist a přesně přenáší vzor masky na vrstvu fotorezistu. Doba vývoje je také kritická – příliš krátká vede k neúplnému vývoji, příliš dlouhá způsobuje zkreslení vzoru.
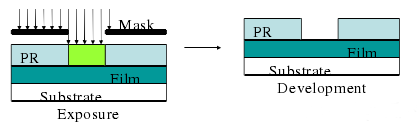
Následně tvrdé vypalování posiluje přilnavost filmu fotorezistu k substrátu a zlepšuje jeho odolnost proti leptání. Teplota tvrdého pečení je obecně mírně vyšší než teplota předpečení.
Nakonec mikroskopická kontrola ověří, zda vzor odpovídá očekávání. Po přenesení vzoru na materiál jinými procesy fotorezist splnil svůj účel a musí být odstraněn. Metody stripování zahrnují mokré (použití silných organických rozpouštědel, jako je aceton) a suché (použití kyslíkové plazmy k odleptání filmu).
2. Dopingové techniky
Doping je v polovodičové technologii nepostradatelný, protože podle potřeby mění elektrické vlastnosti polovodičových materiálů. Mezi běžné dopingové metody patří tepelná difúze a iontová implantace.
(1) Iontová implantace
Iontová implantace dopuje polovodičový substrát tím, že jej bombarduje vysokoenergetickými ionty. Oproti tepelné difuzi má mnoho výhod. Ionty vybrané hmotnostním analyzátorem zajišťují vysokou dopingovou čistotu. Po celou dobu implantace zůstává substrát při pokojové teplotě nebo mírně vyšší. Lze použít mnoho maskovacích fólií, jako je oxid křemičitý (SiO2), nitrid křemíku (Si3N4) a fotorezist, které poskytují vysokou flexibilitu s technikami samonastavitelných masek. Dávky implantátů jsou přesně kontrolovány a distribuce iontů implantovaných nečistot je rovnoměrná ve stejné rovině, což má za následek vysokou opakovatelnost.
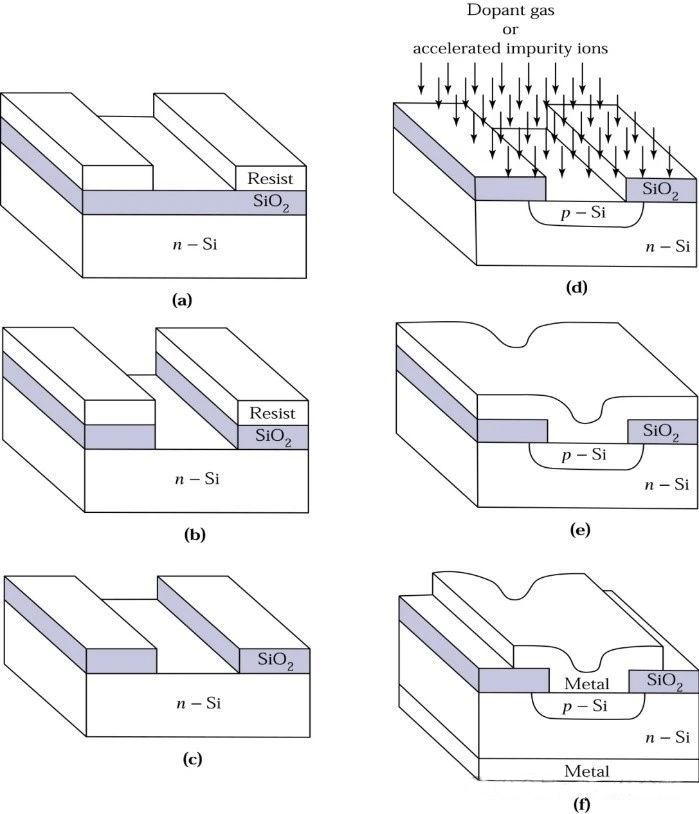
Hloubka implantace je určena energií iontů. Regulací energie a dávky lze manipulovat s distribucí iontů nečistot v substrátu po implantaci. Vícenásobné implantace s různými schématy mohou být prováděny kontinuálně pro dosažení různých profilů nečistot. Je pozoruhodné, že v monokrystalických substrátech, pokud je směr implantace paralelní s krystalografickým směrem, dochází k efektům kanálků – některé ionty se budou pohybovat podél kanálů, což ztěžuje kontrolu hloubky.
Aby se zabránilo vytváření kanálků, implantace se typicky provádí pod úhlem přibližně 7° k hlavní ose monokrystalického substrátu nebo pokrytím substrátu amorfní vrstvou.
Iontová implantace však může výrazně poškodit krystalovou strukturu substrátu. Vysokoenergetické ionty při srážce přenášejí energii do jader a elektronů substrátu, což způsobuje, že opouštějí mřížku a tvoří páry defektů intersticiální vakance. V závažných případech může být krystalová struktura v některých oblastech zničena a tvoří se amorfní zóny.
Poškození mřížky výrazně ovlivňuje elektrické vlastnosti polovodičového materiálu, jako je snížení mobility nosiče nebo životnost nerovnovážných nosičů. A co je nejdůležitější, většina implantovaných nečistot zabírá nepravidelná intersticiální místa a nedokáže vytvořit účinný doping. Proto je nezbytná oprava poškození mřížky po implantaci a elektrická aktivace nečistot.
(2)Rychlé tepelné zpracování (RTP)
Tepelné žíhání je nejúčinnější metodou pro úpravu poškození mřížky způsobené implantací iontů a elektricky aktivujícími nečistotami. Při vysokých teplotách se páry defektů intersticiální-vakance v krystalové mřížce substrátu rekombinují a zmizí; amorfní oblasti budou také rekrystalizovat z rozhraní s jednokrystalovými oblastmi prostřednictvím epitaxe v pevné fázi. Aby se zabránilo oxidaci materiálu substrátu při vysokých teplotách, musí se tepelné žíhání provádět ve vakuu nebo v atmosféře inertního plynu. Tradiční žíhání trvá dlouho a může způsobit významné přerozdělení nečistot v důsledku difúze.
PříchodRTP technologieřeší tento problém a do značné míry dosahuje opravy poškození mřížky a aktivaci nečistot během zkrácené doby žíhání.
V závislosti na zdroji tepla,RTPse dělí na několik typů: skenování elektronovým paprskem, pulzní elektronové a iontové paprsky, pulzní lasery, lasery s kontinuální vlnou a širokopásmové nekoherentní světelné zdroje (halogenové lampy, grafitové ohřívače, obloukové lampy), přičemž poslední jmenované jsou nejpoužívanější. Tyto zdroje dokážou zahřát substrát na požadovanou teplotu během okamžiku, čímž v krátké době dokončí žíhání a účinně sníží difúzi nečistot.
3. Techniky nanášení filmu
(1) Plasma-Enhanced Chemical Vap Deposition (PECVD)
PECVD je jedna z forem techniky chemické depozice z plynné fáze (CVD) pro nanášení filmu, přičemž další dvě jsou CVD za atmosférického tlaku (APCVD) a CVD za nízkého tlaku (LPCVD).
V současné době je PECVD ze všech tří typů nejrozšířenější. Využívá radiofrekvenční (RF) plazma k iniciaci a udržení chemických reakcí při relativně nízkých teplotách, čímž usnadňuje nanášení filmu při nízkých teplotách s vysokými rychlostmi nanášení. Schéma jeho vybavení je znázorněno na obrázku.
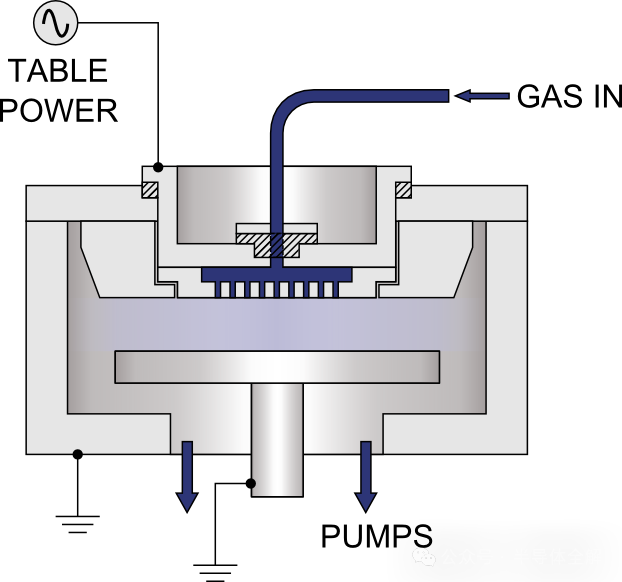
Filmy vyrobené touto metodou vykazují výjimečnou přilnavost a elektrické vlastnosti, minimální mikroporéznost, vysokou uniformitu a robustní schopnosti plnění v malém měřítku. Faktory ovlivňující kvalitu depozice PECVD zahrnují teplotu substrátu, průtok plynu, tlak, RF výkon a frekvenci.
(2) Naprašování
Naprašování je metoda fyzikálního napařování (PVD). Nabité ionty (běžně ionty argonu, Ar+) jsou urychlovány v elektrickém poli a získávají kinetickou energii. Jsou namířeny k cílovému materiálu, narážejí na cílové molekuly a způsobují jejich uvolnění a prskání. Tyto molekuly mají také významnou kinetickou energii a pohybují se směrem k substrátu a ukládají se na něm.

Typicky používané zdroje energie pro naprašování zahrnují stejnosměrný proud (DC) a rádiovou frekvenci (RF), kde je DC naprašování přímo použitelné na vodivé materiály, jako jsou kovy, zatímco izolační materiály vyžadují vysokofrekvenční naprašování pro nanášení filmu.
Konvenční naprašování trpí nízkou rychlostí nanášení a vysokými pracovními tlaky, což má za následek nižší kvalitu filmu. Magnetronové naprašování řeší tyto problémy ideálněji. Využívá vnější magnetické pole ke změně lineární trajektorie iontů na spirálovou dráhu kolem směru magnetického pole, prodlužuje jejich dráhu a zlepšuje účinnost kolize s cílovými molekulami, čímž zvyšuje účinnost rozprašování. To má za následek zvýšení rychlosti nanášení, snížení pracovního tlaku a výrazně lepší kvalitu filmu.
4. Leptání Techniky
Leptání se dělí na suchý a vlhký režim, pojmenované podle jejich použití (nebo nedostatku) specifických řešení.
Leptání typicky vyžaduje přípravu maskovací vrstvy (která může být přímo fotorezistní) pro ochranu oblastí, které nejsou určeny k leptání.
(1) Suché leptání
Mezi běžné typy suchého leptání patříLeptání indukčně vázaným plazmatem (ICP).leptání iontovým paprskem (IBE) a reaktivní iontové leptání (RIE).
Při ICP leptání plazma produkovaná doutnavým výbojem obsahuje četné vysoce chemicky aktivní volné radikály (volné atomy, molekuly nebo atomové skupiny), které chemicky reagují s cílovým materiálem za vzniku těkavých produktů, čímž je dosaženo leptání.
IBE využívá vysokoenergetické ionty (ionizované z inertních plynů) k přímému bombardování povrchu cílového materiálu pro leptání, což představuje fyzikální proces.
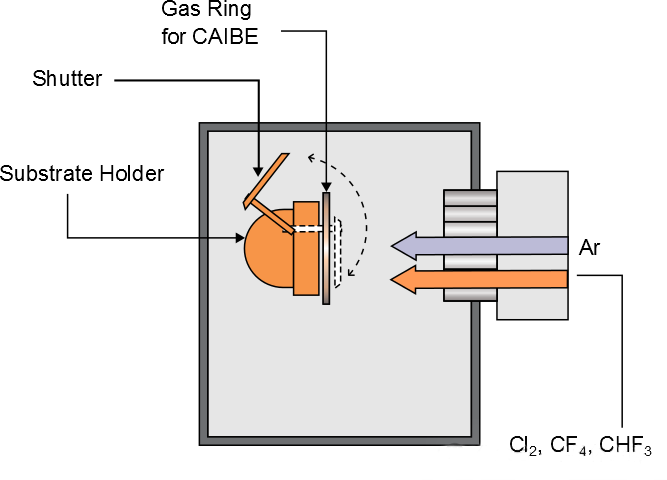
RIE je považována za kombinaci předchozích dvou, nahrazující inertní plyn používaný v IBE plynem používaným při ICP leptání, čímž tvoří RIE.
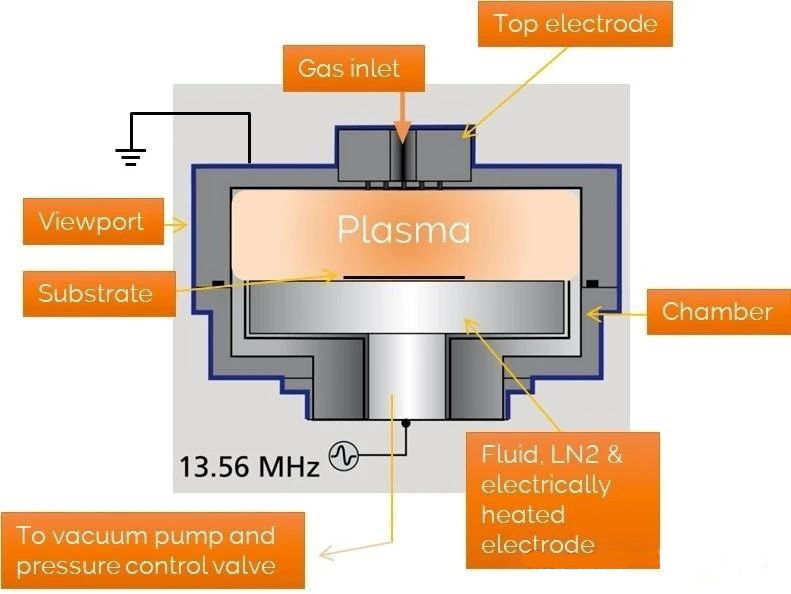
U suchého leptání rychlost vertikálního leptání daleko převyšuje laterální rychlost, tj. má vysoký poměr stran, umožňující přesnou replikaci vzoru masky. Suché leptání však také leptá vrstvu masky, což vykazuje horší selektivitu (poměr rychlosti leptání cílového materiálu k vrstvě masky), zejména u IBE, která může neselektivně leptat přes povrch materiálu.
(2) Mokré leptání
Mokré leptání označuje způsob leptání dosažený ponořením cílového materiálu do roztoku (leptadla), který s ním chemicky reaguje.
Tato metoda leptání je jednoduchá, nákladově efektivní a vykazuje dobrou selektivitu, ale má nízký poměr stran. Materiál pod okraji masky může být zkorodován, takže je méně přesný než suché leptání. Aby se zmírnily negativní dopady nízkého poměru stran, musí být zvolena vhodná rychlost leptání. Mezi faktory ovlivňující rychlost leptání patří koncentrace leptadla, doba leptání a teplota leptadla.**




