
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe ve výrobě čipů: Profesionální zpráva
Evoluce polovodičových materiálů
V oblasti moderních polovodičových technologií posunula neúnavná snaha o miniaturizaci limity tradičních materiálů na bázi křemíku. Aby byly splněny požadavky na vysoký výkon a nízkou spotřebu energie, SiGe (Silicon Germanium) se díky svým jedinečným fyzikálním a elektrickým vlastnostem stal preferovaným kompozitním materiálem při výrobě polovodičových čipů. Tento článek se ponoří doproces epitaxeSiGe a jeho role v epitaxním růstu, aplikacích napjatého křemíku a Gate-All-Around (GAA) struktur.
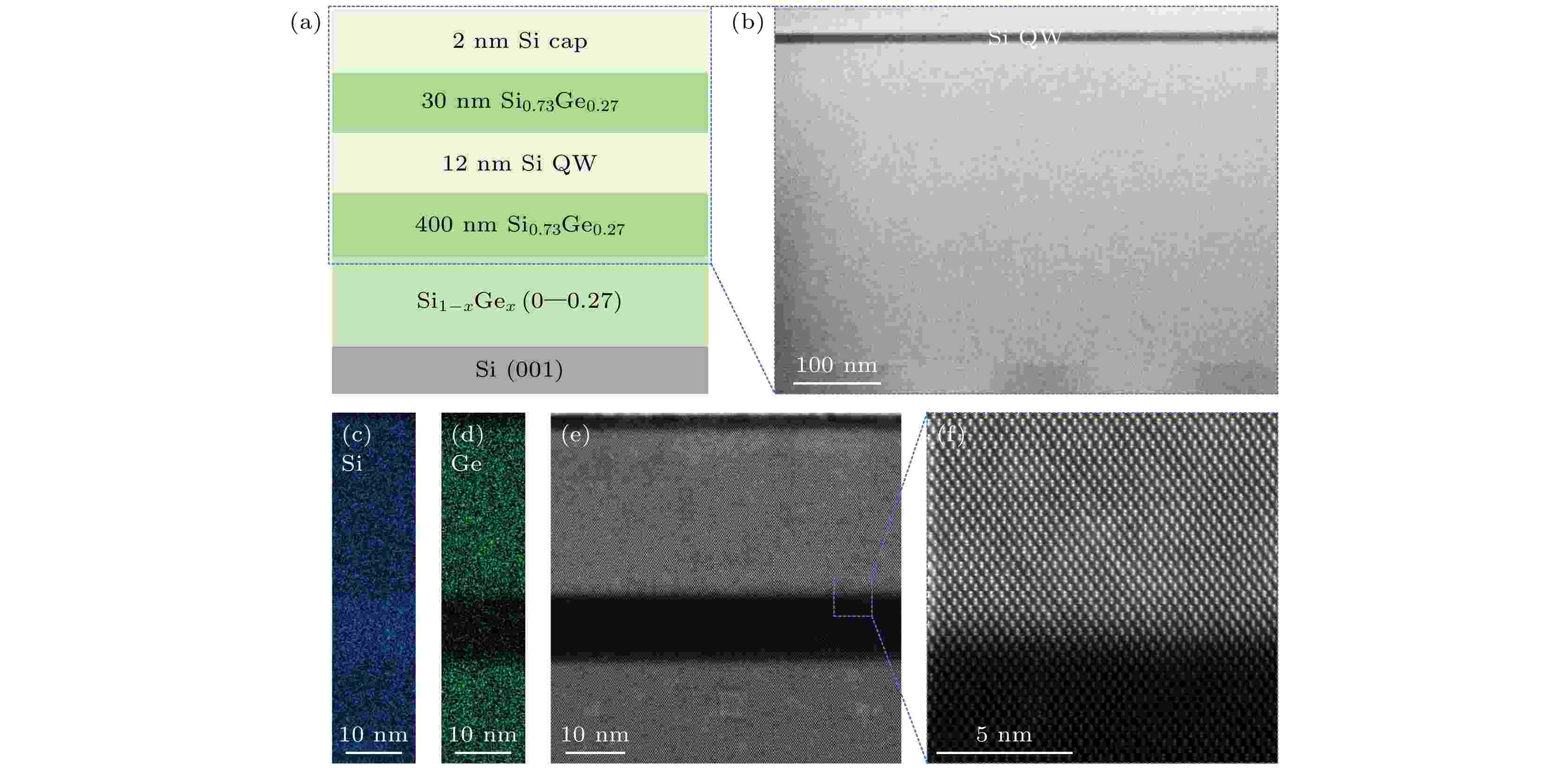
Význam SiGe epitaxe
1.1 Úvod do epitaxe ve výrobě čipů:
Epitaxe, často zkracovaná jako Epi, označuje růst jednokrystalové vrstvy na monokrystalickém substrátu se stejným uspořádáním mřížky. Tato vrstva může být buďhomoepitaxní (jako je Si/Si)nebo heteroepitaxní (jako je SiGe/Si nebo SiC/Si). Pro epitaxní růst se používají různé metody, včetně epitaxe molekulárního paprsku (MBE), ultravysoká vakuová chemická depozice z par (UHV/CVD), atmosférická epitaxe a epitaxe za sníženého tlaku (ATM & RP Epi). Tento článek se zaměřuje na epitaxní procesy křemíku (Si) a křemíku-germania (SiGe), které se široce používají při výrobě polovodičových integrovaných obvodů s křemíkem jako substrátem.
1.2 Výhody SiGe epitaxe:
Začlenění určitého podílu germania (Ge) běhemproces epitaxetvoří monokrystalickou vrstvu SiGe, která nejen snižuje šířku pásma, ale také zvyšuje mezní frekvenci tranzistoru (fT). Díky tomu je široce použitelný ve vysokofrekvenčních zařízeních pro bezdrátovou a optickou komunikaci. V pokročilých procesech integrovaných obvodů CMOS navíc nesoulad mřížky (asi 4 %) mezi Ge a Si zavádí napětí mřížky, čímž se zvyšuje pohyblivost elektronů nebo děr, a tím se zvyšuje saturační proud zařízení a rychlost odezvy.
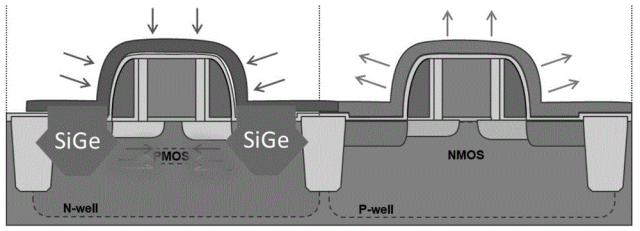
Komplexní tok procesu epitaxe SiGe
2.1 Předúprava:
Křemíkové destičky jsou předběžně upraveny na základě požadovaných výsledků procesu, zahrnujícího především odstranění přirozené oxidové vrstvy a nečistot na povrchu destičky. U silně dopovaných substrátových plátků je zásadní zvážit, zda je zpětné těsnění nutné ke snížení autodopingu během následnéhoepitaxní růst.
2.2 Růstové plyny a podmínky:
Křemíkové plyny: Silan (SiH4), dichlorsilan (DCS, SiH2Cl2) a trichlorsilan (TCS, SiHCl3) jsou tři nejběžněji používané zdroje křemíkového plynu. SiH₄ je vhodný pro nízkoteplotní procesy plné epitaxe, zatímco TCS, známý pro svou rychlou rychlost růstu, se široce používá pro přípravu hustýchsilikonová epitaxevrstvy.
Germaniový plyn: Germane (GeH₄) je primárním zdrojem pro přidávání germania, který se používá ve spojení se zdroji křemíku k vytvoření slitin SiGe.
Selektivní epitaxe: Selektivního růstu je dosaženo úpravou relativních rychlostíepitaxní depozicea leptání in situ za použití křemíkového plynu DCS obsahujícího chlór. Selektivita je způsobena tím, že adsorpce atomů Cl na povrchu křemíku je menší než adsorpce na oxidech nebo nitridech, což usnadňuje epitaxní růst. SiH4, postrádající atomy Cl a s nízkou aktivační energií, je obecně aplikován pouze na nízkoteplotní procesy plné epitaxe. Další běžně používaný zdroj křemíku, TCS, má nízký tlak par a je kapalný při pokojové teplotě, což vyžaduje probublávání H2 pro jeho zavedení do reakční komory. Je však relativně levný a často se používá pro svou rychlou rychlost růstu (až 5 μm/min) k růstu silnějších vrstev křemíkové epitaxe, široce používané při výrobě plátků křemíkové epitaxe.
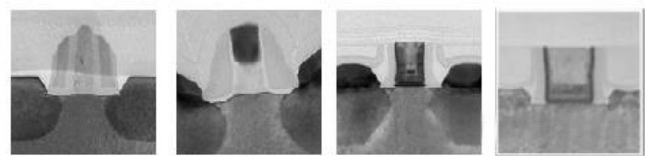
Napnutý křemík v epitaxních vrstvách
Běhemepitaxní růstEpitaxní monokrystalický Si je uložen na uvolněné vrstvě SiGe. V důsledku nesouladu mřížky mezi Si a SiGe je monokrystalická vrstva Si vystavena tahovému namáhání ze spodní vrstvy SiGe, což výrazně zvyšuje mobilitu elektronů v tranzistorech NMOS. Tato technologie nejen zvyšuje saturační proud (Idsat), ale také zlepšuje rychlost odezvy zařízení. U zařízení PMOS jsou vrstvy SiGe po leptání epitaxiálně narůstány ve zdrojové a drenážní oblasti, aby se zavedlo tlakové napětí na kanál, čímž se zvýší pohyblivost otvoru a zvýší saturační proud.
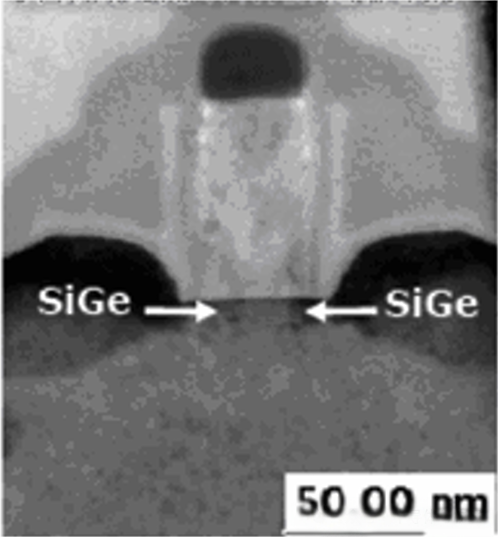
SiGe jako obětní vrstva ve strukturách GAA
Při výrobě nanovláknových tranzistorů Gate-All-Around (GAA) působí SiGe vrstvy jako obětní vrstvy. Techniky anizotropního leptání s vysokou selektivitou, jako je leptání kvaziatomové vrstvy (quasi-ALE), umožňují přesné odstranění vrstev SiGe za vzniku nanodrátových nebo nanovrstvových struktur.
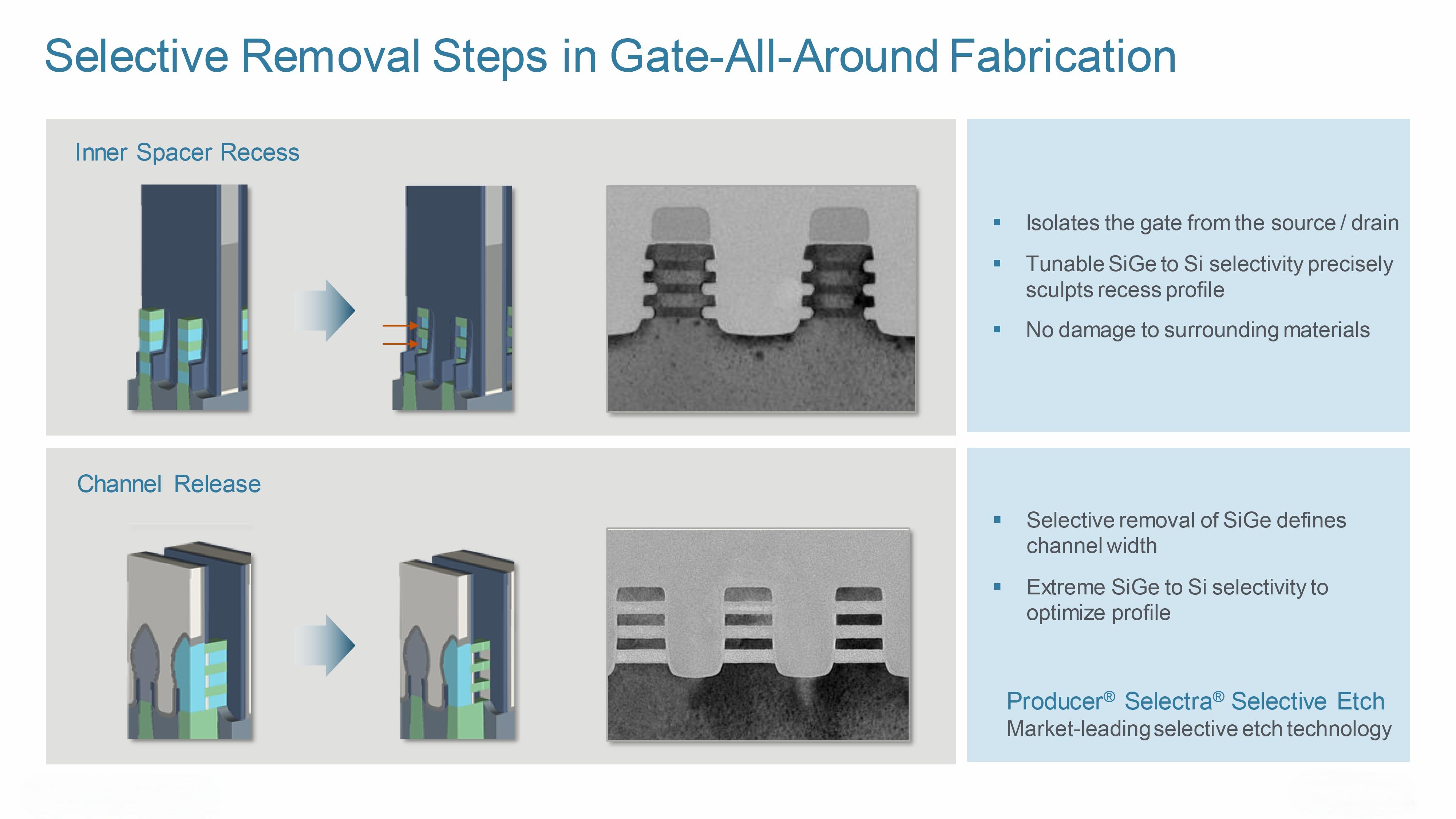
My v Semicorex se specializujeme naGrafitové roztoky potažené SiC/TaCpoužito v epitaxním růstu Si při výrobě polovodičů, pokud máte nějaké dotazy nebo potřebujete další podrobnosti, neváhejte nás kontaktovat.
Kontaktní telefon: +86-13567891907
E-mail: sales@semicorex.com




