
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Technologie selektivního leptání SiGe a Si
Gate-All-Around FET (GAAFET), jako tranzistorová architektura nové generace připravená nahradit FinFET, si získal značnou pozornost pro svou schopnost poskytovat vynikající elektrostatické řízení a zvýšený výkon při menších rozměrech. Kritický krok při výrobě GAAFET typu n zahrnuje vysokou selektivituleptSiGe:Si vrstev před nanesením vnitřních distančních vložek, generováním křemíkových nanovrství a uvolňovacími kanály.

Tento článek se ponoří do výběrutechnologie leptánípodílí na tomto procesu a zavádí dvě nové metody leptání – vysokooxidační bezplazmové leptání a leptání atomové vrstvy (ALE) – které nabízejí nová řešení pro dosažení vysoké přesnosti a selektivity v SiGe leptání.
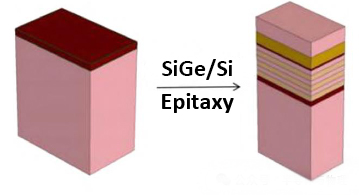
SiGe Superlattice Vrstvy ve strukturách GAA
Při návrhu GAAFET se pro zvýšení výkonu zařízení používají střídavé vrstvy Si a SiGeepitaxně pěstované na křemíkovém substrátu, tvořící vícevrstvou strukturu známou jako supermřížka. Tyto SiGe vrstvy nejen upravují koncentraci nosiče, ale také zlepšují mobilitu elektronů zavedením stresu. V následných krocích procesu však musí být tyto SiGe vrstvy přesně odstraněny a zároveň zachovány křemíkové vrstvy, což vyžaduje vysoce selektivní technologie leptání.
Metody selektivního leptání SiGe
Leptání bez plazmy s vysokým obsahem oxidačního plynu
Výběr plynu ClF3: Tato metoda leptání využívá vysoce oxidační plyny s extrémní selektivitou, jako je ClF3, dosahující poměru selektivity SiGe:Si 1000-5000. Může být dokončen při pokojové teplotě, aniž by došlo k poškození plazmy.
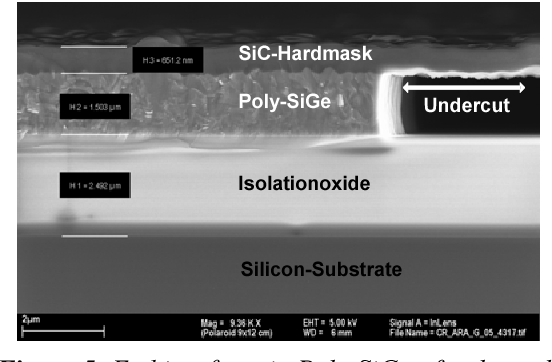
Nízkoteplotní účinnost: Optimální teplota je kolem 30 °C, realizace vysoce selektivního leptání za nízkých teplot, čímž se zabrání dodatečnému navýšení tepelného rozpočtu, což je klíčové pro udržení výkonu zařízení.
Suché prostředí: Celéproces leptáníse provádí za zcela suchých podmínek, čímž se eliminuje riziko adheze struktury.
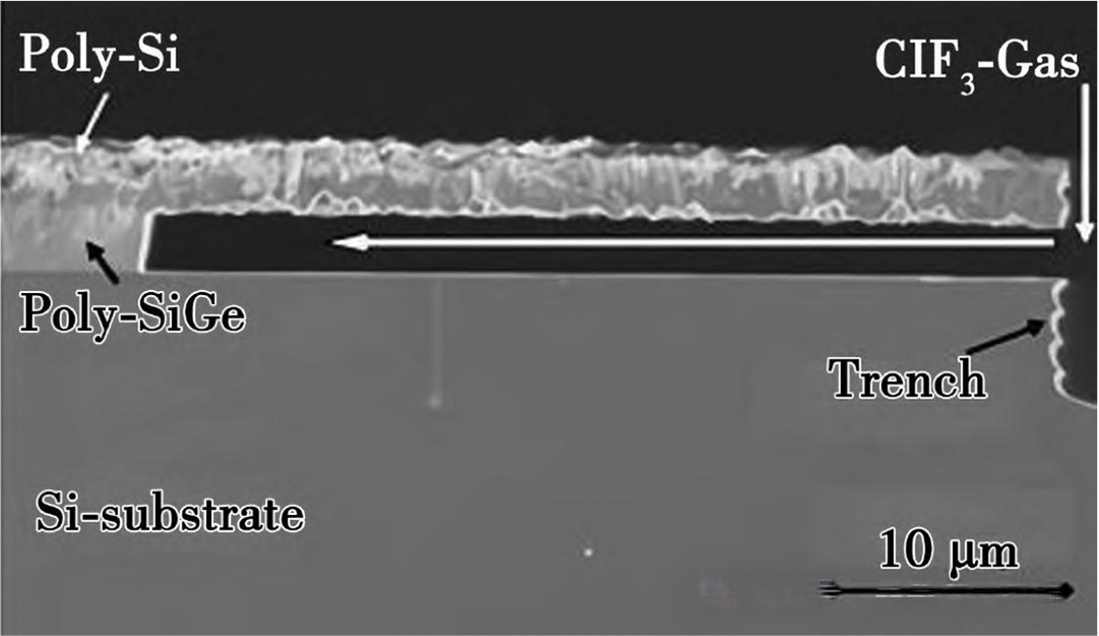
Atomic Layer Etching (ALE)
Samoomezující charakteristiky: ALE je dvoukroková cyklikatechnologie leptání, kde je povrch leptaného materiálu nejprve upraven a poté je upravená vrstva odstraněna bez ovlivnění neupravených částí. Každý krok je samoomezující a zajišťuje přesnost na úroveň odstranění pouze několika atomárních vrstev najednou.
Cyklické leptání: Výše uvedené dva kroky jsou opakovaně cyklovány, dokud není dosaženo požadované hloubky leptání. Tento proces umožňuje ALE dosáhnoutpřesné leptání na atomové úrovniv malých dutinách na vnitřních stěnách.

My v Semicorex se specializujeme naGrafitové roztoky potažené SiC/TaCaplikované v leptacích procesech při výrobě polovodičů, pokud máte nějaké dotazy nebo potřebujete další podrobnosti, neváhejte nás kontaktovat.
Kontaktní telefon: +86-13567891907
E-mail: sales@semicorex.com




