
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Leptající nosič oplatky
Nosič oplatky Semicorex Etching Wafer s CVD SIC povlakem je pokročilý vysoce výkonný roztok přizpůsobený pro náročné polovodičové leptání aplikací. Díky jeho vynikající tepelné stabilitě, chemické odolnosti a mechanické odolnosti z něj činí základní součást moderní výroby oplatky, což zajišťuje vysokou účinnost, spolehlivost a nákladovou efektivitu pro výrobce polovodičů po celém světě.*
Odeslat dotaz
Nosič Etching Wafer Semicorex je vysoce výkonná podpůrná platforma substrátu navržená pro procesy výroby polovodičů, speciálně pro aplikace leptání oplatky. Tento nosič oplatky, navržený s grafitovou základnou s vysokou čistotou a potažený chemickou depozicí páry (CVD) silikonový karbid (SIC), poskytuje výjimečnou chemickou odolnost, tepelnou stabilitu a mechanickou trvanlivost, což zajišťuje optimální výkon ve vysoce přesných leptacích prostředích.
Nosič leptání oplatky je potažen rovnoměrnou vrstvou CVD SiC, což významně zvyšuje její chemickou odolnost proti agresivní plazmě a korozivním plynům používaným v leptacím procesu. CVD je hlavní technologie pro přípravu povlaku SIC na povrchu substrátu v současné době. Hlavním procesem je, že suroviny reaktivních materiálů pro plynnou fázi podléhají řadě fyzikálních a chemických reakcí na povrchu substrátu a nakonec vložte na povrch substrátu, aby se připravily povlak. Potahování SIC připravené technologií CVD je úzce spojeno s povrchem substrátu, který může účinně zlepšit oxidační odolnost a ablační odolnost substrátového materiálu, ale doba depozice této metody je dlouhá a reakční plyn obsahuje určité toxické plyny.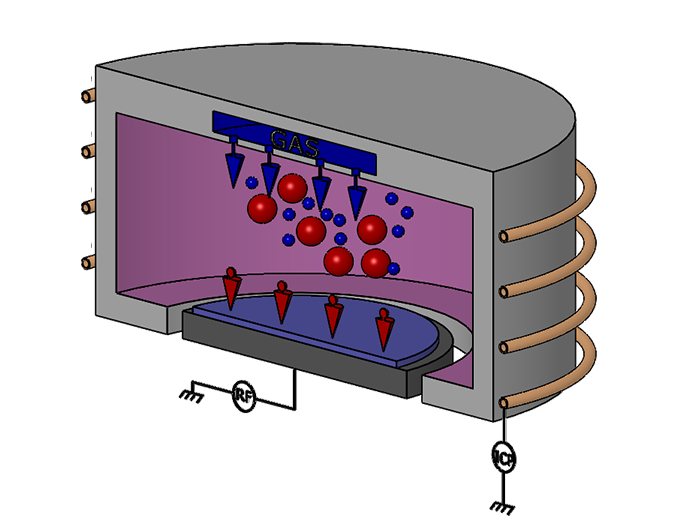
CVD křemíkový karbid povlakDíly se široce používají v leptacím zařízení, zařízení MOCVD, SI epitaxiálním zařízením a sic epitaxiálním zařízením, rychlém tepelném zpracování a dalších polích. Celkově je největším segmentem tržního segmentu CVD Silicon Carbide Coalting součástí leptání a dílů epitaxiálních zařízení. Vzhledem k nízké reaktivitě a vodivosti CVD silikonového karbidu povlaku na chlor a leptané plyny obsahující fluor se stává ideálním materiálem pro zaostření kroužků a dalších částí plazmového leptacího zařízení.CVD SIC částiv leptacím zařízení zahrnujíZaostření prstenů, plynové sprchové hlavy, zásobníky,okrajové kroužky, atd. Vezměte zaostřovací prsten jako příklad. Zaostřovací kroužek je důležitou součástí umístěnou mimo oplatku a v přímém kontaktu s oplatkou. Napětí je naneseno na kroužek, aby se zaostřilo plazmu procházející kroužkem, čímž se zaostřuje plazmu na oplatku, aby se zlepšila uniformita zpracování. Tradiční zaostřovací kroužky jsou vyrobeny z křemíku nebo křemene. S rozvojem miniaturizace integrovaného obvodu se poptávka a význam leptacích procesů ve výrobě integrovaných obvodů zvyšuje a energie a energie leptání plazmy se stále roste.
Povlak SIC nabízí vynikající odolnost proti chemistkám na leptání plazmy na bázi fluoru (F₂) a chloru (CL₂), což zabraňuje degradaci a udržuje strukturální integritu před prodlouženým používáním. Tato chemická robustnost zajišťuje konzistentní výkon a během zpracování oplatky snižuje rizika kontaminace. Nosič oplatky může být přizpůsoben různým velikostem oplatky (např. 200 mm, 300 mm) a specifické požadavky na leptání systému. K dispozici jsou návrhy vlastních slotů a vzory otvorů pro optimalizaci umístění oplatky, řízení toku plynu a účinnost procesu.
Aplikace a výhody
Nosič leptání destičky se primárně používá při výrobě polovodičů pro procesy suchého leptání, včetně leptání v plazmě (PE), reaktivní iontové leptání (RIE) a hlubokého reaktivního iontového leptání (drie). Je široce přijímán při výrobě integrovaných obvodů (ICS), MEMS zařízení, napájecí elektroniky a složené polovodičové oplatky. Jeho robustní povlak SIC zajišťuje konzistentní výsledky leptání tím, že zabraňuje degradaci materiálu. Kombinace grafitu a SIC poskytuje dlouhodobou trvanlivost, snižuje náklady na údržbu a výměnu. Hladký a hustý povrch SIC minimalizuje tvorbu částic a zajišťuje vysoký výnos oplatky a vynikající výkon zařízení. Výjimečná odolnost vůči drsným leptacím prostředím snižuje potřebu častých náhrad a zlepšuje účinnost výroby.













